단품 칩-기판, 수직 와이어 연결
신호 처리 빨라지고 구조 간소화
HBM 이어…‘팬아웃’ 기술 격돌
삼성전자와 SK하이닉스가 모바일 D램에서 첨단 패키징 기술로 맞붙는다.
8일 업계에 따르면 삼성전자와 SK하이닉스는 모바일 D램을 쌓은 뒤 각각의 단품 칩을 기판과 수직 와이어로 연결하는 기술 개발에 착수했다. 삼성전자는 이를 '저전력 와이드 입출력' 기술이라고 명명했으며, SK하이닉스는 '버티컬 팬아웃(VFO)'이라고 부른다. 삼성은 이르면 내년 하반기 양산 기술 확보가 목표다. SK하이닉스는 지난해 VFO 기술을 공개하고 현재 양산 적용을 준비하고 있다.

최근 스마트폰이나 노트북 시장 화두는 온디바이스 AI다. 기기 단에서 인공지능(AI)을 구현하는 것으로, 데이터를 처리할 모바일 D램 성능 개선이 요구된다.
이에 메모리 제조사들은 모바일 D램도 고대역폭메모리(HBM)처럼 적층하는 기술로 대응하고 있다. 모바일 D램 쌓아 올려 데이터 처리 용량을 끌어올리는 방식이다.
데이터센터나 서버에 쓰는 HBM은 미세 구멍을 뚫어(TSV) 칩을 연결한다. 그러나 모바일 D램은 칩이 작아 같은 방법을 쓸 수 없다. 또 대량 양산이 필요한 모바일 D램 특성상 이같은 방법은 비용 부담이 크다.
고안해 나온 개념이 입출력 단자를 수직으로 연결하는 것이다. 모바일 D램을 계단식으로 쌓은 뒤 기둥을 세우듯 기판과 연결, 신호 전달 속도를 높이고 반도체 구조도 더 간소화된다.
이 기술을 활용하면 기존 대비 모바일 D램 입출력 수도 대폭 늘릴 수 있다. 현재 와이어 본딩 방식은 입출력 수가 64개 수준이지만, 신기술은 512개이상 확보할 수 있는 것으로 알려졌다. 입출력 수가 늘면 데이터 처리 속도가 빨라져 고성능을 구현하게 된다.
반도체 업계 관계자는 “모바일 D램 고객사들이 이같은 첨단 패키징으로 신호 입출력 수를 늘리고 성능을 끌어올려달라는 요청을 많이 하고 있다”고 밝혔다.

삼성전자와 SK하이닉스는 모바일 D램에서도 패키징 경쟁력에 따라 승부가 날 것으로 본다. 누가 더 효율적으로 D램을 패키징하느냐가 HBM을 좌우했던 것처럼 모바일 D램에서도 똑같이 재현될 가능성이 높다. 특히 양사가 거의 동일한 패키징 기술을 모바일 D램 양산 로드맵에 포함시키면서 진검 승부가 예상된다.
업계에서는 구체적으로 팬아웃 패키징 기술이 승부를 가를 것으로 내다봤다. 기존 웨이퍼 안에서 입출력 단자를 만드는 것을 '팬인', 웨이퍼(반도체 다이) 크기를 넘어서 입출력 수를 확대하는 것을 '팬아웃'이라고 부른다. 저전력 와이드 입출력, VFO를 구현하려면 이 팬아웃 패키징 기술이 꼭 필요하다.
패키징 업계 관계자는 “삼성전자와 SK하이닉스 모두 팬아웃 패키징을 미래 기술로 낙점, 역량을 끌어올리는데 총력을 기울이고 있다”고 전했다.
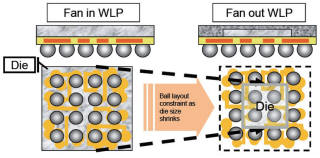
권동준 기자 djkwon@etnews.com












































