네패스가 차세대 패키징 기술로 불리는 '팬아웃-패널레벨패키징(FO-PLP)' 양산을 개시했다. 양산 제품은 전력관리반도체(PMIC)로, FO-PLP를 적용한 PMIC 패키징 양산은 이번이 처음이다. 네패스는 FO-PLP 생산 능력을 지속 확대, 차세대 패키징 시장 선점에 나선다.

4일 업계에 따르면 네패스는 최근 충북 괴산군 청안면 FO-PLP 공장 가동에 돌입했다.
글로벌 반도체 팹리스의 PMIC 제품을 FO-PLP로 양산하고 있다. 월 생산능력은 사각 패널 기준으로 1000장으로 알려졌다. 원형 웨이퍼 패키징으로 따지면 5000장 수준이다. 초도 물량이라 소규모지만 차세대 패키징 기술인 FO-PLP로 PMIC를 양산한 세계 최초 사례라 주목된다.
네패스가 양산 개시한 FO-PLP는 차세대 패키징 기술 중 하나다. 팬아웃(FO)은 반도체 입·출력 단자(I/O)를 칩 바깥으로 배치, I/O 수를 늘릴 수 있는 기술이다. 칩 전기적 성능과 열 효율성을 높이는 데 유리하다. 패널레벨패키징(PLP)은 사각형 패널 위에 칩과 기기를 직접 연결, 패키징하는 방식이다. 사각형이라 원형 대비 버리는 테두리를 최소화할 수 있다. 그만큼 많은 칩을 생산할 수 있다는 의미다. 이런 강점 덕분에 웨이퍼레벨패키징(WLP)보다 앞선 기술로 평가된다.
네패스가 청안 공장에 도입한 FO-PLP 공정은 600㎜ 정사각형 패널을 활용한다. 12인치(300㎜) 원형 웨이퍼 한 장 대비 약 5배 많은 칩(다이)을 생산할 수 있다. 고객사 입장에서는 PMIC의 높은 생산성을 확보, 시장 경쟁력을 갖출 수 있을 것으로 예상된다. 보통 PLP는 WLP 방식보다 생산성이 96% 높다고 평가 받는다.
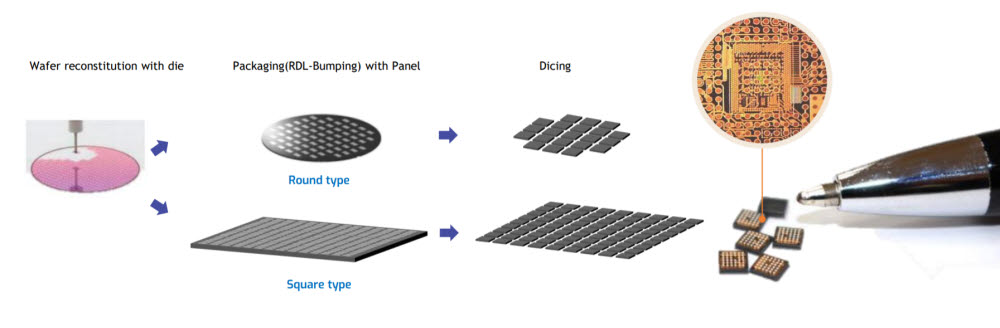
네패스는 PMIC 수요 확대에 따라 생산 능력을 지속 확대할 계획이다. 연말까지 3배 이상 생산능력을 확대, 내년 상반기에는 월 3000장 패널 생산 능력을 확보할 것으로 전해진다. 원형 웨이퍼로 환산하면 월 1만5000장 수준이다. 네패스는 고객사 주문량이 점차 확대될 것으로 고려, 추가 생산라인 증설도 검토 중인 것으로 알려졌다. 네패스 관계자는 “고객사와 계약으로 구체적인 사항에 대해 공개하기 어렵다”고 말을 아꼈다.
네패스의 양산 개시에 따라 글로벌 FO-PLP 시장도 성장에 돌입할 것으로 전망된다. FO-PLP는 첨단 패키징 기술인만큼 아직 시장 규모가 크지 않다. 현재 네패스와 삼성전자, 일부 대만 패키징 업체만 FO-PLP 기술을 가지고 있다. 시장조사업체 욜디벨롭먼트에 따르면, FO-PLP 시장은 2018년 기준 1800만달러에서 2024년 1억1900만달러로 성장할 것으로 보인다.
권동준기자 djkwon@etnews.com












































