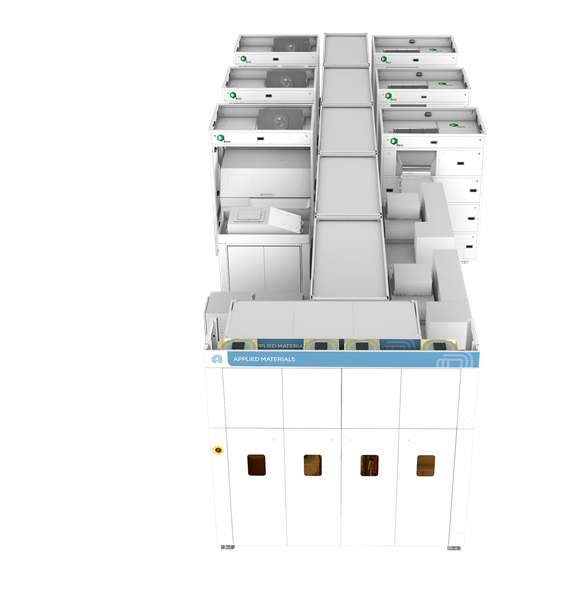
어플라이드 머티어리얼즈가 베시와 협력, 반도체 '하이브리드 본딩' 장비 개발에 성공했다.
하이브리드 본딩은 반도체나 웨이퍼를 솔더 볼과 같은 추가 접합 소재 없이 직접 연결하는 차세대 기술로, 고대역폭메모리(HBM) 등 수직 적층이 필요한 첨단 반도체 패키징 시장 공략을 본격화할 전망이다.
어플라이드는 최근 업계 최초 '다이 투 웨이퍼(Die to Wafer)' 하이브리드 본딩 장비 '키넥스 본딩 시스템'을 개발했다고 밝혔다.
네덜란드 첨단 패키징 장비 기업 베시와의 협력한 첫 성과다. 어플라이드는 지난 4월 베시(BE세미컨덕터 인더스트리즈) 지분 9%를 인수해 최대 주주에 올랐다.
하이브리드 본딩 장비는 서로 다른 반도체(다이)와 웨이퍼를 연결하는데 쓰인다. HBM을 예로 들면, D램과 D램을 연결하기 위해 실리콘관통전극(TSV)에 구리를 채워 이를 직접 접합하는 기술(Cu to Cu)이다.
현재 HBM 제조에는 D램 사이에 솔더볼(마이크로 범프)이라는 중간 접합 소재가 들어간다. 이는 HBM 높이가 높아지고 저항으로 인한 발열 등 문제를 야기할 수 있다. 하이브리드 본딩은 솔더볼을 쓰지 않아 얇은 HBM을 고성능으로 구현할 수 있다.
이같은 장점에 삼성전자·SK하이닉스 등 HBM 제조사도 하이브리드 본딩 기술 도입을 추진하고 있다. 이르면 20단 HBM부터 하이브리드 본딩 기술을 적용할 것이란 게 중론이다.
어플라이드는 이같은 수요를 조준했다. 회사는 지금까지 웨이퍼에 회로를 구현하는 증착·식각·산화·CMP 등 전(前) 공정 장비에 주력했다. 최근에는 첨단 패키징 시장 성장에 대응, 본딩 및 유리기판 공정 장비에 대대적인 후(後) 공정 장비 연구개발(R&D)에 투자하고 있다.
베시의 지분 인수와 하이브리드 본딩 장비 개발 역시 이같은 투자 일환이다. 업계 관계자는 “어플라이드가 첨단 패키징 분야를 새로운 성장동력으로 삼고 신규 장비 등 포트폴리오 확대를 추진하고 있다”고 전했다.
어플라이드는 2나노미터(㎚) 이하 게이트올어라운드(GAA) 구조를 위한 에피택셜(성장 공정) 장비 '센츄라 엑스테라 에피 시스템'도 선보였다. GAA는 핀펫에 이은 차세대 트랜지스터 구조로, 어플라이드는 신규 장비를 통해 기존 대비 가스 사용량을 50% 절감하고 반도체 셀 간 균일성을 40% 이상 향상시킬 수 있다고 설명했다. 3차원(3D) 반도체를 정밀하게 계측, 수율 개선에 기여할 수 있는 '프로비전 10 이빔 계측 시스템'도 출시했다.
권동준 기자 djkwon@etnews.com