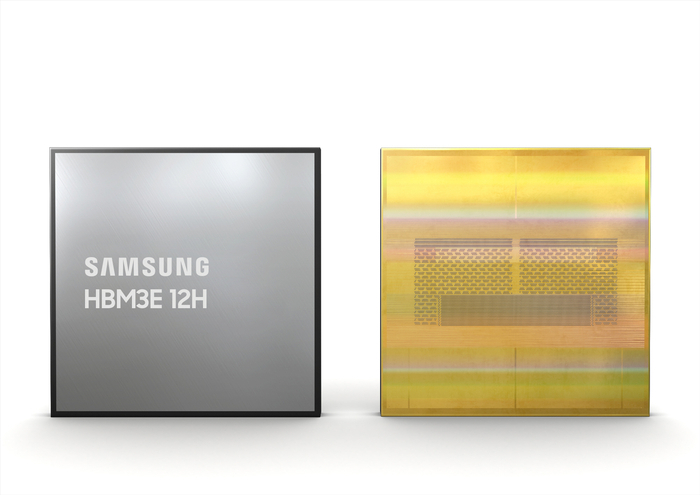
삼성전자가 반도체 수직 적층용 접합 소재를 이원화한다. 고대역폭메모리(HBM)는 기존에 활용했던 '비전도성필름(NCF)'을 유지하고, 시스템 반도체에는 '몰디드언더필(MUF)'을 도입하는 투트랙 전략이다. 공정 소재 전환보다는 성능 혁신으로 HBM 시장에서 승부를 보려는 판단이 깔렸다.
업계에 따르면, 삼성전자는 HBM을 위·아래로 붙이는 소재로 NCF를 유지하는 것으로 알려졌다. 인공지능(AI)용 메모리로 손꼽히는 HBM은 D램을 여러 단으로 쌓아 제조한다. 이때 D램을 서로 접합하는 소재가 필요한데, 삼성전자는 NCF라는 필름을 사용한다.
업계에서는 삼성전자가 SK하이닉스와 견줘 HBM 경쟁 우위를 확보하지 못한 이유로 이 NCF를 지목해왔다. 발열 제어 등 소재 성능이 SK하이닉스의 액체성 소재인 MUF, 좀 더 구체적으로는 매스리플로우(MR)-MUF 대비 뒤처진다는 것이다. 실제 SK하이닉스도 HBM2(2세대)까지는 NCF를 사용했지만, 이후 HBM2E(3세대)부터는 MR-MUF로 전격 교체했다. SK하이닉스의 HBM 시장 영향력이 확대된건 이때부터라는 것이 업계 중론이다.
삼성전자 역시 HBM에 MUF 적용을 시도했던 것으로 알려졌다. 그러나 검토 수준에 그치고, NCF를 유지하는 쪽으로 가닥을 잡은 것으로 파악됐다. NCF를 MUF로 변경하려면 장비 등 상당한 변화를 줘야하는데, 시장 상황 상 공정 전환은 사실상 불가능하기 때문이다.
반도체 업계 관계자는 “삼성이 NCF에서 MUF로 소재를 전환하고 이에 최적화된 공정 환경을 구축하려면 최소 1년 이상 걸린다”면서 “치열한 HBM 시장 쟁탈전이 진행되는 상황에서 1년은 시장을 포기하겠다는 것과 다름 없다”고 말했다. 빠른 양산 전략으로 시장을 맹추격해야하는 상황에서 HBM 핵심 기술을 바꿀 수 없다는 것이다.
삼성전자가 올해 초 일본 토와로부터 MUF를 딱딱하게 굳히는 장비를 사들여 HBM에 적용하는 것이 아니냐는 관측이 나왔지만, HBM 접합을 위한 장비는 아닌 것으로 전해진다.
대신 삼성은 NCF 성능 고도화를 택했다. 단점으로 지목된 발열과 두께를 대폭 개선한 NCF를 연이어 확보했다. 지금까지 NCF를 공급했던 레조낙(옛 쇼와덴코) 뿐 아니라 LG화학까지 공급망에 합류시켜 차세대 제품도 개발하고 있다.
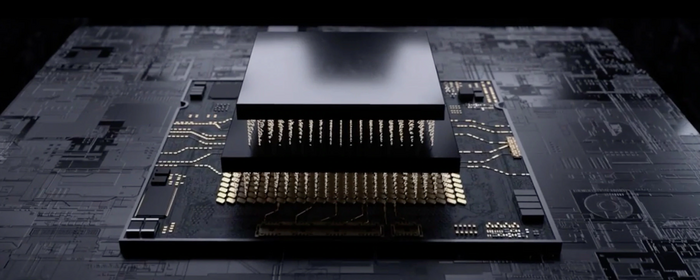
반면 시스템 반도체 패키징에는 선택지를 넓혔다. 3차원(3D) 반도체 패키징 기술이 확산되면서 시스템 반도체도 수직 적층을 위한 접합 소재가 필요해졌는데, 여기에 NCF 뿐 아니라 MUF까지 적용할 방침이다. 시스템 반도체 패키징은 HBM과 달리 SK하이닉스와 직접 경쟁하지 않는데다 시장 공략을 위한 다양한 시도가 필요하기 때문이다. 업계 관계자는 “현재 시스템 반도체에 MUF 소재를 적용하는 초기 단계 연구가 진행되고 있다”며 “삼성의 독자적인 MUF 소재를 개발 및 도입하려는 전략”이라고 말했다.

권동준 기자 djkwon@etnews.com

































