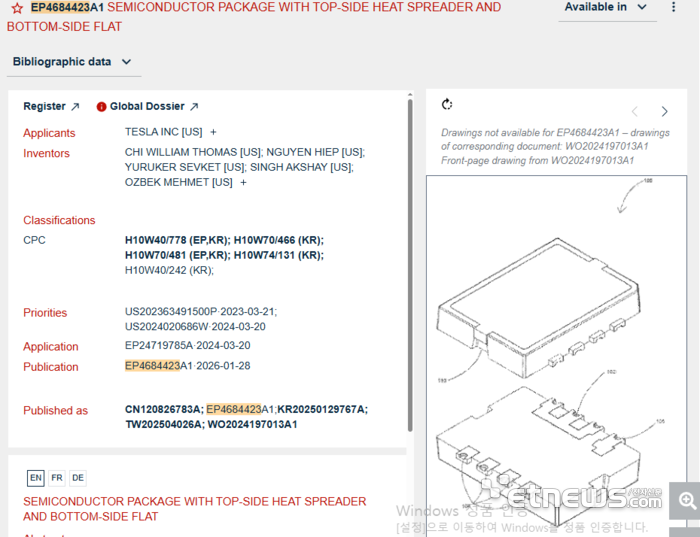
테슬라가 전력 반도체의 열 관리와 전기적 효율을 개선한 새로운 패키징 기술을 공개했다. 고전압 시스템 전환에 따른 열적 한계를 하드웨어 구조 변경으로 해결하려는 의도로 풀이된다.
4일 테슬라의 최신 유럽 특허(EP4684423)에 따르면 테슬라는 최근 '상면 방열판을 갖춘 반도체 패키지(Semiconductor Package with Top-Side Heat Spreader)' 기술 개발에 성공했다. 해당 개념은 2024년에 최초 공개됐지만 이번 특허에서 기술이 구체화되고 양산성을 확보했다.
이 기술의 핵심은 실리콘카바이드(SiC) 칩 윗부분을 덮는 거대한 구리 블록이다. 기존 반도체 패키지가 얇은 리드프레임을 사용하는 것과 달리, 테슬라는 전기 배선(Lead)보다 최대 3배나 두꺼운 구리 덩어리를 칩 상단 면적의 80% 이상 덮도록 설계했다.
이는 일종의 '열 배터리(Thermal Battery)' 역할을 한다. 전기차가 정지 상태에서 급가속하거나 초급속 충전 시 발생하는 순간적인 열 스파이크를 이 구리 덩어리가 스펀지처럼 먼저 흡수한다. 냉각 시스템이 작동하기 전 칩이 열로 파손되는 것을 막는 '방열 갑옷(Thermal Armor)'인 셈이다.
전기적 효율 측면에서도 혁신을 보였다. 테슬라는 기존 자동차 반도체에서 흔히 쓰이던 '갈매기 날개(Gull-wing)' 형태의 굽어 있는 리드 설계를 버리고, 평평하고 짧은 플랫(Flat) 리드를 도입했다.
다리가 짧아지면 전기가 이동하는 경로에서 발생하는 저항과 노이즈인 '기생 인덕턴스(Parasitic Inductance)'가 줄어든다. 이는 테슬라가 추진 중인 48V 아키텍처와 차세대 질화갈륨(GaN) 반도체의 초고속 스위칭 성능을 온전히 끌어내기 위한 필수 조치로 풀이된다.
제조 방식은 금속판을 기계로 찍어내는 스탬핑(Stamping) 공법을 적용했다. 기존 정밀 패키징 공정에서는 통상 사용되는 화학적 식각(Etching)이나 물리적 연마(Grinding)이 아니라 차별화된다. 또한 '무가공 성형(Molded to Net Shape)' 기술을 통해 몰드에서 나오자마자 별도의 후공정 없이 바로 사용할 수 있게 설계됐다. '성능 저하 없는 원가 절감”을 하드웨어 수준에서 구현한 셈이다.
업계에서는 이번 패키징 기술이 사이버트럭이나 테슬라 세미 등 고전압·대용량 배터리가 필요한 차량에 우선 적용될 것으로 예상하고 있다. 800V 시스템은 충전 속도를 높일 수 있지만 발열 관리가 까다로운데, 테슬라가 자체 패키징 기술로 이 병목 현상을 어느 정도 해결했기 때문이다. 기존 하면냉각(Bottom-Side Cooling) 위주로 개발해왔던 국내 기업들에게는 이 새로운 기술이 리스크로 작용할 수 있다.
업계 관계자는 “국내 기업들이 성능을 맞추기 위해 값비싼 절삭 가공이나 화학 공정을 쓴다면 단가 경쟁에서 밀리게 된다”며 “단순 칩 제조를 넘어 테슬라의 파워트레인 하드웨어와 결합되는 패키징 솔루션을 요구받게 될 것”이라고 설명했다.
이형두 기자 dudu@etnews.com












































