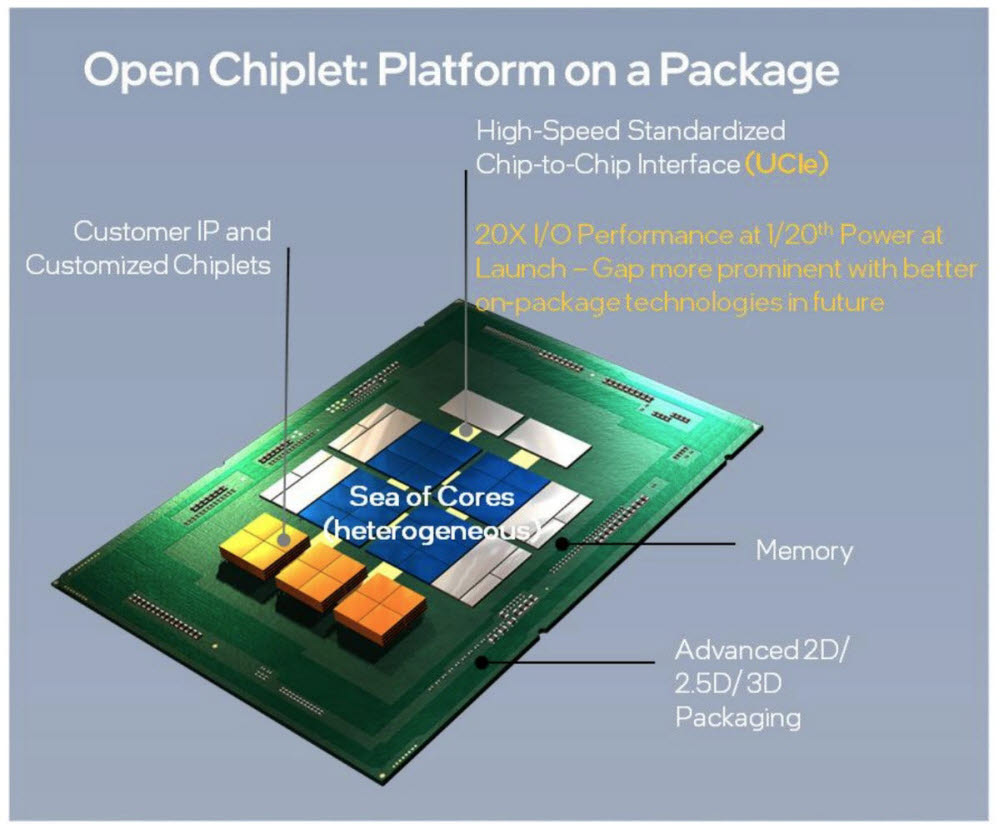
반도체 기업 패키지 전쟁은 3차원(3D) 적층 등 차세대 기술뿐 아니라 인프라 투자에서도 한창이다. 인텔은 '종합반도체기업(IDM) 2.0' 비전을 발표하고 대대적 투자에 나섰다. TSMC와 삼성전자도 대규모 패키지 투자를 통해 패권 경쟁에 뛰어들었다.
시장조사업체 욜디벨롭먼트에 따르면 지난해 반도체 패키지에 가장 많이 투자를 한 기업은 인텔이다. 인텔은 35억달러(약 4조2000억원)를 투입했다. 2021년 반도체 패키지 전체 투자 가운데 30% 정도를 차지했다. TSMC가 30억달러로 뒤를 이었다. ASE가 3위, 삼성전자가 4위다.
인텔의 적극적 투자는 내년 하반기 양산을 앞둔 차세대 3D 패키지 기술인 포베로스 옴니와 포베로스 다이렉트 생산 인프라를 구축하기 위한 것으로 풀이된다. 인텔은 2019년 발표한 3D 적층 기술 포베로스를 고도화, 패키지 분야 선두를 달리는 TSMC를 맹추격하고 있다.
인텔은 미국 뉴멕시코 공장을 증설, 후공정 인프라 증설에 들어갔다. 여기에만 약 35억달러가 투입된다. 말레이시아, 이탈리아에도 각각 70억달러와 88억달러를 투입, 패키지 공장을 조성할 계획이다.
TSMC 역시 패키지 분야에 적극 투자하고 있다. 올해 일본 이바라키현에 반도체 제조공장(팹)을 건설하겠다고 밝혔다. 지난해 패키징 공장 150억달러 투자 계획의 일환이다. 일본 정부는 TSMC 연구개발(R&D) 거점 마련에 1억5800만달러 보조금을 지원한다. TSMC는 해당 거점에서 일본 소재·부품·장비(소부장) 업체와 협렵해 후공정 기술 연구를 수행한다. TSMC는 대만을 비롯한 동남아시아 패키지 생산 허브를 활용, 후공정 경쟁력을 확대할 것으로 예상된다.
삼성전자도 반도체 패키지 경쟁력 확보를 위해 관련 조직을 확대했다. 삼성전자 DS부문 글로벌 제조&인프라 총괄에 테스트&패키지(TP) 센터를 이관했다. 글로벌 제조&인프라 총괄은 반도체 제조에 필요한 설비부터 가스, 화학, 전기는 물론 환경 안전까지 모든 인프라를 구축, 운영한다. 기존 독립된 조직을 인프라 투자 총괄로 옮긴 만큼 대대적인 패키지 설비 투자가 예상된다.
경쟁이 치열하지만 끈끈한 협업 관계도 무시할 수 없다. 패키지를 비롯한 반도체 산업은 소부장뿐 아니라 팹리스까지 탄탄한 생태계를 통해 성장할 수 있기 때문이다. 대표적인 협력 사례는 최근 발표된 패키지 산업 표준이다. 삼성전자와 TSMC, 인텔 등이 주도해 차세대 반도체 패키지 산업 표준을 제정하기로 했다. 협력체에는 AMD·퀄컴, ARM, 구글, 메타, 마이크로소프트 등도 참여한다. 반도체 패키징 표준을 단일화하면서 새로운 생태계를 조성하고, 패키징, 3D 적층 등 분야에서 기업간 협업을 촉진하는 것이 목표다.
반도체 업계는 반도체 패키지 인프라 투자 확대와 협력 가속화 시 시장 성장이 한층 빨라질 것으로 기대한다. 반도체 회로 미세화를 위한 전공정 대비 투자가 미비했으나 반도체 성능 향상을 위해 기술과 인프라 투자에 나설 전망이다.
김지웅기자 jw0316@etnews.com